Giới thiệu
Quan sát các dislocation (hiện tượng biến dạng) là vô cùng quan trọng để phân tích cấu trúc của các vật liệu tinh thể. Hình 1 thể hiện một hình ảnh quét điện tử kính hiển vi (SEM) về dislocation trong silic được thu được thông qua kỹ thuật hình ảnh tương phản kênh điện tử (ECCI). Trong những năm gần đây, đã có thể chụp được hình ảnh SEM về dislocation với độ rõ nét không thua kém so với hình ảnh TEM. Tuy nhiên, hầu hết các nghiên cứu báo cáo quan sát ECCI về dislocation chưa tối ưu hóa cẩn thận điều kiện chiếu tia electron, và trong nhiều trường hợp, phân tích cấu trúc con của dislocation chỉ được xử lý bán định lượng. Đối với việc đặc trưng chính xác về chuyển động và mật độ dislocation, việc sử dụng phân tích g·b để xác định vector Burgers và làm rõ khả năng nhìn thấy hoặc không nhìn thấy dislocation dưới điều kiện quan sát cụ thể là rất quan trọng. Ngoài ra, hướng xạ của tia electron (e-beam) phải được xác định chính xác khi ước tính độ sâu xuyên thấu của tia electron (khoảng cách tắt) trong hình ảnh ECCI. Chỉ khi có thông tin chi tiết về loại này, quan sát ECCI về cấu trúc dislocation mới có thể tái tạo chất lượng của quan sát TEM.
|
Hình 1: Sự biên dạng trong silicon được quan sát thông qua SEM-ECCI. |
Các kỹ thuật để xác định hướng xạ của tia electron (e-beam) trong SEM bao gồm phương pháp electron channeling pattern (ECP), selected-area electron channeling pattern (SACP), cũng như phương pháp electron back-scattered diffraction (EBSD). Lịch sử phát triển của lĩnh vực này đã tiến từ phương pháp ECP và SACP đến phương pháp EBSD để cho phép ánh xạ hướng tinh thể với tốc độ cao hơn. Do đó, sự phát triển của EBSD tạm thời khiến ECP và SACP trở nên lỗi thời. Tuy nhiên, gần đây, những phương pháp này đã trở lại được chú ý do nhu cầu xác định hướng xạ của tia electron một cách chính xác với độ chính xác cao trong quan sát ECCI định lượng. Trong bài báo này, chúng tôi trình bày một số ví dụ minh họa về quan sát ECCI được tăng cường bằng phương pháp SACP, được thực hiện bằng hệ thống SEM được trang bị bộ điều khiển góc nghiêng của tia electron. |
Tổng quan về phương pháp ECP và SACP
Như đã đề cập trước đó, EBSD là phương pháp phổ biến nhất để xác định hướng xạ của tia electron trong SEM. Tuy nhiên, việc sử dụng EBSD để đo đạc hướng tinh thể yêu cầu mẫu được nghiêng với góc khoảng 70°, điều này gây khó khăn vì khi áp dụng để suy ra hướng xạ của tia electron trong trạng thái không nghiêng, đã được báo cáo rằng có thể phát sinh lỗi lên đến 2°2). Khi xác định một hướng xạ tia electron phù hợp để sử dụng trong quan sát ECCI, lỗi có kích thước như vậy là không thể chấp nhận được, và do đó, thực hiện quan sát ECCI định lượng dựa trên dữ liệu hướng tinh thể từ EBSD - mặc dù không hoàn toàn không thể - là rất khó khăn.
Điều này thúc đẩy việc xem xét ECP và SACP như những phương pháp thay thế cho EBSD để xác định hướng xạ của tia electron. Hình 2(a) hiển thị một hình ảnh phản xạ electron quay lại (BSE) của silicon tinh thể đơn, được thu được ở độ phóng đại thấp (×50). Mặc dù mẫu là tinh thể đơn, một mẫu hình học xuất hiện trên bề mặt mẫu; đây được gọi là mẫu hình kênh electron (ECP). Khi quan sát hình ảnh SEM ở độ phóng đại thấp, góc giữa tia xạ và bề mặt mẫu thay đổi đáng kể tùy thuộc vào vị trí quét tia electron, như được minh họa trong sơ đồ chiếu tia xạ electron trong Hình 3(a). Khi hướng xạ tia electron xảy ra thoả mãn điều kiện Bragg, độ sáng BSE trở nên yếu, và do đó, hình ảnh BSE hiển thị một mẫu hình đặc trưng phản ánh sự biến thiên trong hướng xạ tia electron; đó chính là ECP3). Vì ECP phản ánh hướng tinh thể của mẫu, nó có thể được phân tích để xác định hướng xạ của tia electron. Một cách khác, khi cố định điểm chiếu tia electron và thay đổi góc nghiêng của tia electron chiếu xạ (được gọi là khóa tia), sẽ tạo ra một mẫu hình tương tự được gọi là mẫu hình kênh electron khu vực lựa chọn (SACP), như được hiển thị trong Hình 3(b). Hình 2(b) hiển thị một SACP được thu được tại cùng vị trí mẫu như trong Hình 2(a). Như những hình ảnh này chứng minh, các hình ảnh SACP thu được với việc sử dụng bộ điều khiển góc nghiêng tia electron tiết lộ các mẫu hình tương tự như trong hình ảnh ECP, nhưng với độ rõ nét và sắc nét hơn, và do đó, phương pháp SACP có thể xác định hướng xạ của tia electron một cách chính xác hơn so với phương pháp ECP.
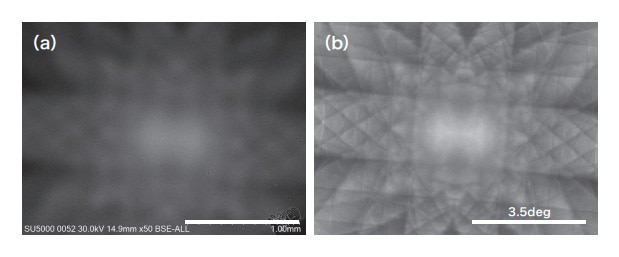
Fig. 2 (a) BSE image of single crystalline Si sample acquired at low magnification. (b) SACP acquired for same sample.
|
Một trong những ưu điểm quan trọng nhất của SACP so với ECP là độ phân giải không gian cao hơn. Như rõ ràng từ Hình 2(a), để đảm bảo một phạm vi đủ rộng của góc nghiêng tia electron cho hình ảnh ECP, cần phải có trường nhìn lớn, trên thứ tự của vài milimét; do đó, trong thực tế, phương pháp ECP để xác định hướng xạ chỉ áp dụng được cho các mẫu tinh thể đơn hoặc mẫu có hạt tinh thể rất lớn. Ngược lại, việc sử dụng một bộ điều khiển góc nghiêng tia electron phù hợp - như bộ điều khiển góc nghiêng tia electron được lắp đặt trên Hitachi SU5000 - cho phép thu được hình ảnh SACP cho các vùng chiếu xạ nhỏ chỉ cỡ 5 μm. Một vấn đề phức tạp của phương pháp SACP là tác động của hiện tượng lệch cầu ống kính trở nên đặc biệt rõ ràng ở các góc nghiêng cao. Vì vậy, các hệ thống SEM hiện đại có chế độ SACP được trang bị khả năng điều chỉnh lệch cầu ống kính để cho phép cả góc nghiêng cao và các vùng chiếu xạ siêu nhỏ. Hình 4 minh họa quá trình hiệu chuẩn bộ hiệu chỉnh lệch cầu ống kính như vậy, trong trường hợp này sử dụng một lưới Cu với độ dày xấp xỉ 5 μm và khoảng cách lưới xấp xỉ 25 μm. Khi quá trình hiệu chuẩn đang diễn ra [Hình 4(a)], một số đường lưới rõ ràng hiển thị trong trường nhìn, và vùng chiếu xạ mở rộng trên một khu vực rộng khoảng 200 μm. Ngoài ra, số lượng đường lưới khác nhau hiển thị ở phần trên và dưới của trường nhìn, cho thấy vùng không được chiếu xạ đồng đều. Sau khi hiệu chuẩn [Hình 4(b)], giao điểm của các đường lưới mở rộng trên toàn bộ trường nhìn, và kích thước vùng chiếu xạ được giảm xuống chỉ còn 5 μm.
|
Fig. 3 Schematic diagrams illustrating e-beam irradiation configurations for (a) ordinary SEM scanning, (b) SACP acquisition. Source: Taken from the instruction manual for the SU5000 e-beam tilt controller. |
Ví dụ này cho thấy phương pháp SACP, áp dụng cho các hạt tinh thể riêng lẻ trong các mẫu đa tinh thể, có khả năng xác định hướng xạ của tia electron với độ chính xác cao, trong khoảng 0.1° 4). Trong quá trình đo đạc như vậy, khả năng chuyển đổi giữa các chế độ quan sát ECCI và SACP chỉ bằng một nút nhấn - mà không cần điều chỉnh góc nghiêng mẫu hoặc bất kỳ điều kiện quan sát nào khác - rất quý giá. Để tạo một đối chiếu với các phương pháp quan sát TEM tiêu chuẩn, phương pháp quan sát ECCI này giống với khả năng xen kẽ giữa việc thu thập hình ảnh TEM và mẫu kết tinh trong quá trình điều chỉnh điều kiện quan sát và tìm kiếm các vùng quan sát mục tiêu.
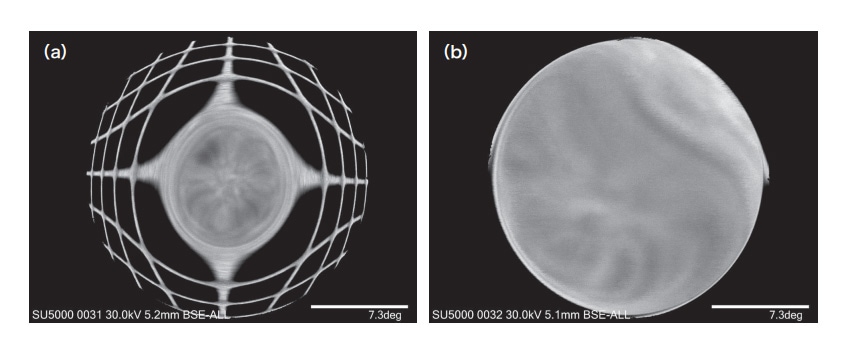
Fig. 4 Calibration of spherical aberration corrector in SACP mode. (a) Calibration in progress. (b) Calibration complete
Độ phân giải không gian của SACP
Hình 5 trình bày kết quả quan sát trong đó mỗi việc thu thập hình ảnh ECCI được tiếp theo bằng việc thu thập hình ảnh SACP. Mẫu trong trường hợp này là một hợp kim niken đa tinh thể. Hình 5(a-c) là các hình ảnh ECCI, trong khi Hình 5(d-f) là các hình ảnh SACP được thu thập từ các điểm chiếu xạ được chỉ định bằng các dấu chéo trong các hình ảnh ECCI. Đối với các hạt tinh thể nằm ở vị trí của các dấu chéo trong Hình 5(a) và 5(c), chúng ta thu được hình ảnh SACP rõ ràng, với các hướng tinh thể ở trung tâm của các hình ảnh SACP tương ứng với hướng xạ tia electron trong các hình ảnh ECCI. Ngược lại, hình ảnh SACP trong Hình 5(e) được chụp ở vùng lân cận trực tiếp của ranh giới hạt tinh thể, và hiển thị sự giao thoa của các mẫu trong Hình 5(d) và 5(f). Ví dụ này cho thấy hình ảnh SACP rõ ràng có thể được thu được tại các điểm quan sát trong bên trong các hạt tinh thể tương đối lớn. Tuy nhiên, hình ảnh SACP cho các điểm quan sát bên trong các hạt tinh thể nhỏ hơn 10 μm hoặc các điểm quan sát gần ranh giới hạt tinh thể phản ánh sự ảnh hưởng của nhiều hạt lân cận, và do đó phải được hiểu biết cẩn thận. Vì các lý do tương tự, hình ảnh SACP có xu hướng mờ khi biến dạng đã buộc một sự xoay của hướng tinh thể bên trong một hạt. Vì lý do này, các chiến lược để giảm kích thước vùng chọn trong quan sát SACP đã được thực hiện trong một số nghiên cứu gần đây, trong đó báo cáo các kỹ thuật kết hợp khóa tia và dịch tia2,4) hoặc khóa sân3) cho phép giảm kích thước vùng chọn đến tỷ lệ siêu vi môn.
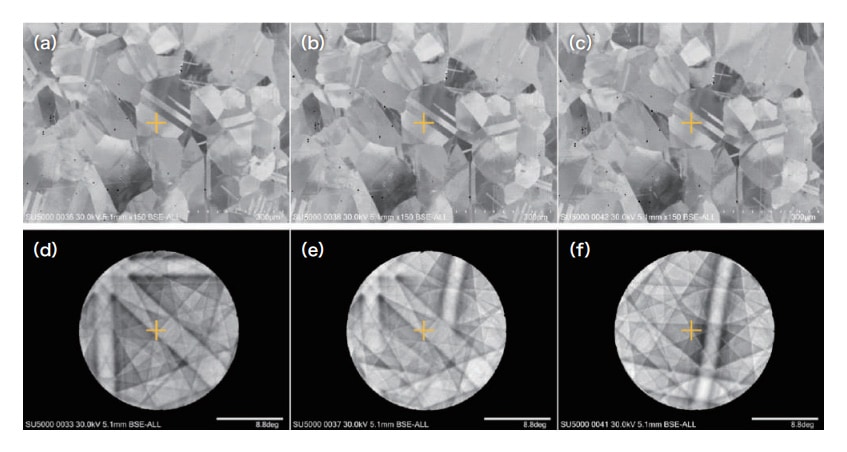
Fig. 5 (a-c): ECCI images of polycrystalline nickel-based alloy sample. (d-f): SACP images acquired for observation points indicated by crosses in ECCI images.
Sử dụng SACP để xác định hướng tác động của tia điện tử (e-beam)
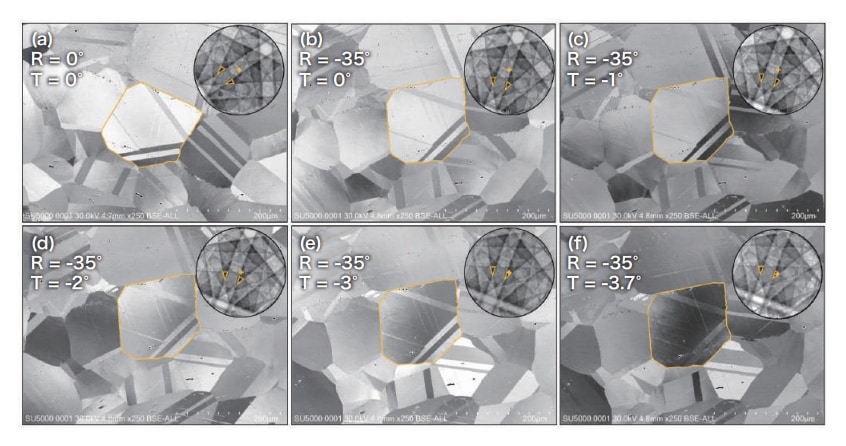
|
Hình 7 là một hình ảnh ECCI về các lỗi dislocation được chụp ở độ phóng đại cao cho cấu hình mẫu trong Hình 6(f); lưu ý rằng các đường dislocation và lỗi xếp chồng rõ ràng nhìn thấy trong hình ảnh này. Ví dụ này cho thấy việc sử dụng SACP làm cho việc nghiêng mẫu đến các hướng thoả mãn điều kiện kênh hóa dễ dàng, cho phép quan sát dislocations trong các hạt tinh thể tùy ý quan tâm. |
Fig. 7 ECCI image of dislocations captured for configuration in Figure 6(f). |
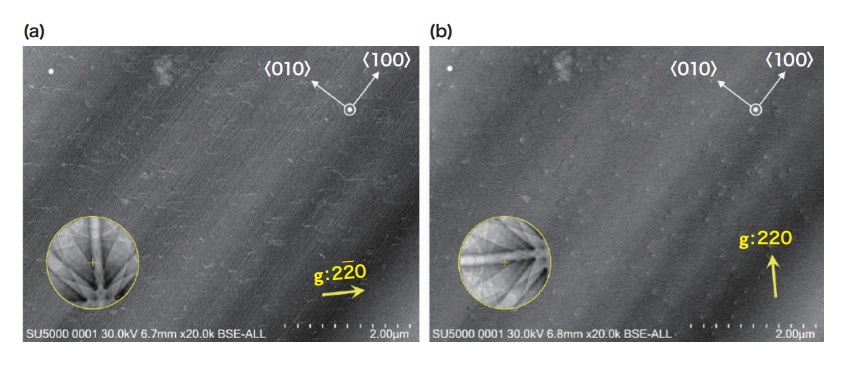
Fig. 8 ECCI dislocation images of same field of view observed for different incidence directions. (a) g=20, (b) g=220.
Các ứng dụng tiềm năng trong phân tích căng lưới tinh thể
Trước khi kết thúc, chúng ta tóm tắt một mục đích khác mà kỹ thuật SACP có thể sớm trở nên hữu ích: đo căng lưới tinh thể. Các kỹ thuật hiện có để đo căng lưới tinh thể trong mẫu tinh thể bao gồm kỹ thuật tán xạ tia X (XRD) và tán xạ điện tử trong góc hẹp (CBED), nhưng cả hai phương pháp này đều có nhược điểm. Thông tin thu được từ XRD được lấy trung bình không gian trên toàn bộ mẫu, trong khi mẫu CBED là các lớp mỏng và do đó có thể không phản ánh chính xác các đặc tính căng lưới của vật liệu toàn bộ. Một phương án thay thế cho những phương pháp này là phương pháp EBSD (còn được gọi là phương pháp Wilkinson), có thể đo căng lưới tinh thể trong các vùng có kích thước con submicron của vật liệu toàn bộ với các kích thước phù hợp với mẫu SEM. Phương pháp Wilkinson đo căng lưới tinh thể bằng cách phát hiện các thay đổi trong chiều rộng của các dải Kikuchi do sự dịch chuyển trong các vùng quan tâm trong các mẫu Kikuchi. Nếu cứng đàn hồi của vật liệu được biết, phương pháp này cho phép hình dung phân bố căng thẳng tại mỗi vị trí đo EBSD.
|
Fig. 9 SACP for silicon sample captured at high magnification. |
Tuy nhiên, một hạn chế của phương pháp Wilkinson là độ phân giải thấp khi đo căng lưới tinh thể. Độ phân giải của các máy ảnh EBSD thông thường - trên thứ tự của 1.000×1.000 điểm ảnh - khó có thể coi là đủ để đo sự dịch chuyển thông qua kỹ thuật tương quan hình ảnh, và độ phóng đại của hình ảnh mẫu là cố định và không thể thay đổi. Những yếu tố này hạn chế độ phân giải căng lưới tinh thể của phương pháp Wilkinson. Ngược lại, các hệ thống SEM có thể thu thập hình ảnh độ phân giải cao với hơn 5.000 điểm ảnh hoặc nhiều hơn trên mỗi chiều. Hơn nữa, với SACP dựa trên hình ảnh SEM, có thể thu thập hình ảnh với độ phóng đại tăng cao, như được thể hiện trong Hình 9. Do đó, khả năng thu thập hình ảnh SACP cho phép sử dụng những "gauge" dài hơn khi sử dụng phương pháp tương quan hình ảnh để đo sự dịch chuyển của các dải Kikuchi, từ đó hứa hẹn độ phân giải căng lưới tốt hơn. Tuy nhiên, như đã đề cập ở trên, các vùng được chọn sẵn có trong các phương pháp SACP hiện nay khá lớn - trong khoảng vài micromet - và do đó không thể thu thập hình ảnh SACP rõ ràng cao cho các mẫu mà căng lưới tinh thể thay đổi trong vùng được chọn. Do đó, để sử dụng thành công SACP như một công cụ cho phân tích căng lưới tinh thể, có thể yêu cầu cải tiến đáng kể về độ phân giải không gian của SACP, như đã thảo luận trong Phần 3. |
Kết luận
Trong bài viết này, chúng tôi đã trình bày một số nghiên cứu thực tế để chứng minh tính hữu ích của quan sát ECCI dựa trên SACP. Để khai thác toàn bộ tiềm năng của phương pháp ECCI để quan sát cấu trúc dọc tinh thể, quan trọng là những phân tích định lượng khác nhau mà chúng tôi đã thảo luận phải dễ dàng thực hiện. Hiện nay, rất ít hệ thống SEM được trang bị bộ điều khiển nghiêng e-beam. Tuy nhiên, trong tương lai, chúng tôi kỳ vọng sẽ sớm có thể chọn các phương pháp cụ thể để thu thập các mẫu điện tử giao thoa cho các ứng dụng và mục tiêu cụ thể - chẳng hạn như phương pháp EBSD cho việc ánh xạ hướng tinh thể tốc độ cao và phương pháp SACP cho việc thu thập mẫu và kiểm soát chính xác hướng tia e-beam - từ đó mở ra những tiến bộ tiếp theo trong kỹ thuật SEM cho phân tích cấu trúc của các vật liệu tinh thể.
*****************************************************************
Để được tư vấn và biết thêm thông tin chi tiết, xin vui lòng liên hệ:
Công ty TNHH Sao Đỏ Việt Nam